PKG
- FCBGA
- FCCSP
- CSP
- SIP, AIP
- FCBOC
FCBGA (Flip Chip Ball Grid Array)
적용분야
주로 CPU와 ASIC 반도체 패키징에 사용되며, Chip과 기판을 Solder Bump로 연결하여 Gold Wire에 비해 빠른 속도와 더 많은 배선이 가능하다는 장점이 있는 BGA 기판입니다.
주요기술
FCBGA 기판의 핵심 기술은 16층 이상의 고다층 빌드업 공법과 10um 미만의 초미세 회로 형성, 130um 이하의 솔더범프 형성,그리고 50x50mm 이상의 대면적 기판 제조 공법 등으로서,
대덕전자의 FCBGA 전용 생산라인은 자동차용 MPU, 초고속 통신칩, 그리고 데이터센터 프로세서 등의 FCBGA에서 요구되는 기술 수준을 목표로 개발 및 양산 진행되고 있습니다.- FCBGA package는 Chip의 솔더범프를 전기적으로 접속하고, 외부 환경으로부터 칩을 보호하는 역할을 합니다.
- 대덕전자의 FCBGA 기판은 Build-up 기술과 SAP 기술을 접목한 고다층 첨단 패키지 Substrate이며, FCBGA package의 기본 토대와 전기 접속의 경로를 제공합니다.
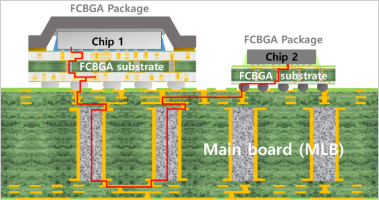
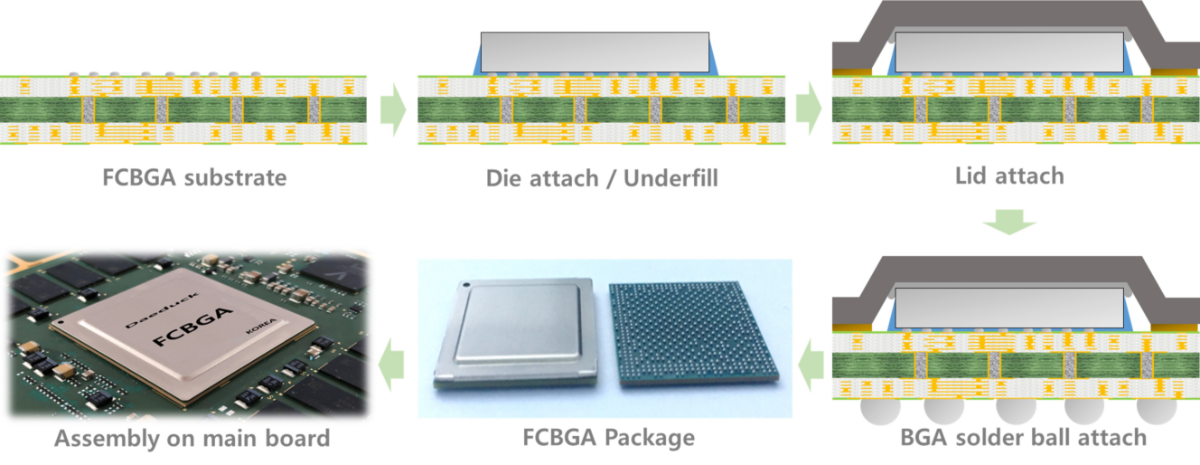
FCCSP (Flip Chip Chip Scale Package)
적용분야
FCCSP는 모바일 AP, 고성능 워크 스테이션, 서버, 데이터 송수신 제품, 인터넷 라우터 등 전기적 성능이 필수적인 고속/RF 패키징 분야에 널리 활용 되며 이를 겨냥한 제품입니다.
Wire bond roof가 없기 때문에 Die 까지의 거리 및 연결이 적어 inductanc를 유지 하면서도 밀도가 높아 고주파 신호선에 최적화된 전기적 경로를 결정 할 수 있어 활용 범위가 매우 넓습니다.주요기술
FCCSP는 일반 wire bonding 방식과 달리 와이어를 사용하지 않고 Chip-PKG substrate간 bump 직접 연결을 통하여 향상된 전기적 성능과 집적도 증가, 와이어 공간 제거를 통한 소형화 구현이 가능합니다.
CSP (Chip Scale Package)
적용분야
Chip면적이 Package 면적의 80% 이상인 제품을 말하며, 주요 Applications으로는 Flash Memory, Mobile DRAM 제품이 있습니다.
주요기술
Thin structure
Substrate의 두께가 박판화에 따라 제품 구동간 불량 risk 증가로 high stiffness 소재를 적용하여 제품 구동성 확보하여 양산성을 확대 할 수 있습니다.Warpage control
기판의 휨(warpage)을 관리하기 위해서 열조건, Substrate의 volume을 control하여 warpage를 관리 할 수 있습니다.
- MASS
- SAMPLE
Structure 2L ~ 6L 2L ~ 6L Substrate
Thickness2L 80㎛ 75㎛ 3L 80㎛ 70㎛ 4L 110㎛ 100㎛ Bond finger Pitch 60P (32/15, Ni 3) 55P (25/15, Ni 2) Line Width/Space (/w mSAP) 40Pitch (20/20㎛) 32Pitch (16/16㎛) SR Registration 15㎛ 12㎛ SiP (System In Package)
적용분야
SiP PKG는 기능 단위의 모듈을 말하며, 이 자체로 시스템 레벨 제조의 표준 부품으로 사용 가능한 제품 입니다.
보통 하나 이상의 와이어 접속 또는 플립칩 접속된 반도체와 수동소자등으로 구성되며 다양한 기능을 하나의 패키지에 집적시켜 전체 시스템의 크기를 줄이고, 성능과 신뢰성을 향상 시킬 수 있습니다.
RF와 무선장치(Power Amp. GPS모듈, 핸드폰), Networking과 Computing 등에 널리 적용되고 있습니다.주요기술
Core층을 사용하지 않는 Coreless 기판은 두께를 더욱 더 얇게 만들 수 있습니다.
Coreless 기판은 Build up layer만으로 Substrate를 만드는 방식으로 두께를 Cored Type 대비 더 얇게 만들 수 있는 장점이 있습니다.
그 외에도 Package 전체 인덕턴스, 전체적인 신호 신뢰성을 높이는 장점이 있습니다.
Cored Type


Coreless Type
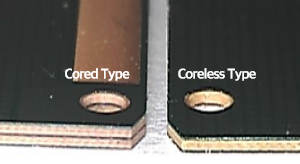
AiP (Antenna In Package)
적용분야
Substrate 안에 안테나 기능을 구현한 기판으로 송수신 칩셋부터 필터, 전력 증폭기 등의 다양한 전자부품과 통신 모듈을 하나의 안테나 패키지로 통합한 기판 솔루션 입니다.
주요기술
5G 스마트폰이 보급되면서 5G 송수신을 위한 안테나를 Substrate로 구현한 AiP 형태의 PKG 제품 입니다.
안테나를 Substrate로 구현했기 때문에 전송 선로가 짧아져 신호 loss 측면에서 유리한 장점이 있습니다.FCBOC (Flip Chip Board On Chip)
적용분야
신호 손실을 최소화하고, 전송속도를 높이기 위해 Bump를 이용해 칩과 기판간의 거리를 단축하여 연결한 메모리 제품을 일반적으로 FCBOC라고 합니다.
대량 생산과 빠른 속도를 필요로 하는 DRAM 칩에 주로 사용됩니다.
주요기술
Low Dk Material
저유전률 소재 선정과 해당 소재의 공정 최적화를 통해 신호 손실을 최소화한 DRAM Package를 구현할 수 있습니다.Warpage Control
기판의 휨 (Warpage) 발생되면, 칩과 기판 간의 Bump가 연결되지 않는 불량 (Non-wet)이 발생되므로, 공정과 Design을 통해 휨을 제어하여 불량을 방지할 수 있습니다.